什么是引线键合前的等离子清洗?
作者:武汉月忆神湖科技有限公司 2023.01.26 点击1161次
引言: 引线键合(Wire bonding )前的等离子清洗(Plasma cleaning)可去除表面上的有机物、氧化物和氟化物污染物,促进引线键合和芯片封装的更好的界面附着力,并减少不粘焊盘 (NSOP) 和键合提升问题。
一、典型应用 (1)促进引线键合更好的界面附着力 (2)去除表面的有机物、氧化物和氟化物污染 (3)提高芯片粘接工艺的芯片附着力 (4)为倒装芯片应用创建无空隙底部填充 (5)提高芯片板芯片的模具附着力和封装性 二、IC芯片封装简介半导体封装可以弥合硅芯片和PCB之间的尺寸差距。硅芯片上的金属焊盘通常太小,无法直接连接到PCB。封装还可以帮助硅芯片更有效地将热量传导到散热器。在过去的半个世纪里,从 1970 年代到 2020 年,半导体芯片封装从 DIP(双列直插式封装)到 3D IC 发生了显着变化,如下图所示。许多传统的芯片封装技术至今仍在广泛使用,如引线键合BGA和倒装芯片BGA技术。等离子清洗已被广泛用于在键合前清洁芯片、芯片和引线框架,以提高可靠性并降低故障率。 三、IC芯片封装中的污染为了实现可靠的芯片封装,所有内部接口的表面必须清洁,以确保良好的附着力。IC芯片和封装上的污染可以是有机的,也可以是无机的。无机污染物可以是粘合垫上形成的金属氧化物或氟化物。IC封装上的污染源很多。 (1)污染可能来自处理胶带、塑料储存袋、助焊剂和芯片贴装过程中渗出的粘合剂上的许多有机材料。有机化合物可能具有更高的释气率。有机蒸气可以直接覆盖新鲜表面。 (2)含氟气体通常在半导体晶圆厂中用作强蚀刻剂。氟与Al发生轻微反应,在粘接垫表面形成[AlFx](x-3)-(例如[AlF6]3-)或化合物AlxFyOz。这些化合物不能轻易从EKC和DI水清洗过程中洗掉。因此,在粘合垫上检测到一定比例的氟是正常的。 (3)在制造和组装过程中也会产生一定程度的污染,例如未蚀刻的玻璃、硅芯片上的残留光刻胶、硅锯末或背磨或模切过程中的胶带残留物。 (4)环境空气中存在丰富的碳氢化合物污染。一旦焊盘或引线框架暴露在环境空气中,它们很快就会被一层有机碳氢化合物涂覆。对于活性金属,表面会形成一层薄薄的金属氧化物。环境空气引起的污染可以在下面显示的数据中解释。在步骤1中,XPS系统测量了干净的InGaAs样品表面的组成。在步骤2中,通过2秒钟的远程氢等离子体清洁样品。然后通过XPS系统再次分析表面。氢气等离子体清洗步骤不会向表面添加污染物。在步骤3中,将清洁的InGaAs样品暴露在环境空气中1小时。随后的XPS测量表明,表面已被碳和氧污染。在步骤4中,再次用2秒氢等离子体清洁受污染的InGaAs样品。这意味着环境空气很容易污染干净的样品表面。氢等离子体可以成功去除碳污染并减少InGaAs样品上的金属氧化物。
四、污染对引线键合工艺的影响 热超声引线键合是关键的封装工艺之一,特别是对于航空航天和汽车行业,在严苛的条件下,键合接头可能会受到应力。如上一节所述,氟化物、氧化物和有机碳氢化合物等污染物会降低键的界面质量。对于引线键合工艺,它可能会导致诸如不粘焊盘 (NSOP) 和键合提升等问题。不粘焊盘是指表面污染会降低表面粘合性,从而使电线不会粘附在焊盘上的问题。焊盘提升是指焊线从其位置脱落,导致键合线和焊盘之间的电气和机械连接丢失或退化的问题。粘接垫表面的污染物可以作为屏障并防止形成强烈的金属间化合物。因此,粘结通常无法通过拉力测试。氟化物污染会导致长期腐蚀问题。 五、如何使用等离子清洗来提高引线键合和倒装芯片键合的可靠性和成功率等离子体是一种电离气相物质,由离子、电子、中性原子或保持电荷中性的分子组成。为了点燃等离子体,自由移动的电子将被外部电场加速并获得足够的能量来电离沿路径的中性原子或分子。如果使用氧气或氢气产生等离子体,高能电子可以解离氧/氢分子并产生原子氧/氢、臭氧或其他类型的反应自由基。除了活性自由基,等离子体还可以产生高能离子。等离子体与样品相互作用有两种主要机制。第一个是与活性自由基的化学反应。二是物理高能离子溅射。这两种机制在去除引线键合和倒装芯片键合工艺的表面污染物方面都起着重要作用。以下是等离子清洗如何使引线键合和倒装芯片键合工艺受益。 六、等离子清洗可去除引线键合和倒装芯片键合工艺中的有机污染物有机污染是许多引线键合和倒装芯片键合工艺中的主要污染源。幸运的是,活性氧或氢自由基可以快速与表面有机污染物反应,例如碳氢化合物,光刻胶残留物,助焊剂残留物,胶带粘合剂残留物等。等离子刻蚀已广泛用于IC制造工艺,因为它可以精确地去除纳米级的材料。粘合和包装过程中组件的规模通常要大得多。因此,如果有机污染物的厚度超过数十微米,则仅靠等离子清洗过程可能不是很有效。粘合垫表面大多数污染物的厚度在纳米级到几微米的范围内。这些污染物可以在几分钟内通过等离子清洗过程快速去除。如果助焊剂、胶带和粘合剂的残留物厚度超过几微米,则应在等离子清洗步骤之前先进行溶剂清洗过程。 如果有机污染物的厚度在几纳米量级,纯氩等离子清洗工艺也可以通过物理氩离子溅射工艺有效地去除表面污染物。如果芯片、PCB 或引线框架含有容易氧化的活性金属,如银、铜或铝,则不应使用氧等离子体。对于这些样品,应使用纯氩等离子体或与氢气混合的氩气代替。对于金垫,氩气、氧气或氢气等离子体都可以达到良好的效果。在大多数情况下,对于有机材料,氧等离子体的蚀刻速度明显更高。 七、氩气或氩气+氢等离子体可以去除粘接垫上的表面氧化物和氟化物许多金属焊盘在芯片和引线框架存放在周围环境中时很容易被氧化。银垫很容易失去光泽是一个常见问题。当然,氟化物腐蚀是许多过早粘接失效的另一个主要原因。氩离子溅射可以有效去除金属垫表面的一层薄薄的氧化物和氟化物。将氩气与氢气混合生成等离子体也可以通过氢还原反应除去氧化物。但并非所有金属氧化物都可以在室温下被原子氢还原。例如,氢等离子体在室温下不能化学还原氧化铝。氢离子的重量不足以溅射掉表面氧化物或氟化物。重要的是在等离子体中添加较重的氩气,以便高能氩离子可以通过物理离子溅射过程去除表面氧化物和氮化物。等离子清洗只是一个表面过程,因此它不能去除扩散到大部分金属中的氟。 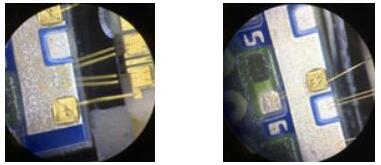 氩等离子清洗前后的银键合垫。 在上面的图片中,氩等离子清洗使失去光泽的银垫在去除表面有机污染物和氧化银层后看起来更明亮、更闪亮。下面的数据显示,在纯氩等离子清洗3分钟后,焊线的拉力显着提高。  八、等离子清洗可以增加表面能并减少底部填充空隙。水滴接触角测量方法已被广泛用作评估样品表面有机污染物厚度的低成本方法。有机污染可以排斥水,从而增加接触角。干净的表面将显着降低接触角。当然,低接触角意味着更高的表面能。对于倒装切屑底部填充应用,高表面能可以显著提高芯吸速度,减少底部填充空隙,并产生均匀的圆角高度。 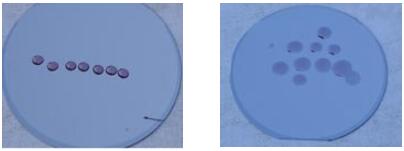 等离子清洗前后的 4“ 晶圆 九、Tergeo等离子清洗机中进行芯片封装前的等离子清洗和引线键合
十、浸没模式与远程模式等离子清洗 在等离子体清洗的浸没模式下,样品直接浸入等离子体中。样品将经历高能离子溅射和与氧或氢自由基的表面化学反应。等离子体还可以产生红外、可见光和紫外光子。一些专用芯片对表面离子溅射、紫外光子辐射或电荷极其敏感。在这种情况下,可以使用更温和的远程等离子清洗模式。在 Tergeo 等离子体系统上的远程等离子体清洗模式下,不会直接在样品室中生成等离子体。它是在连接到样品室的单独等离子体源中产生的。由于样品未浸入等离子体中,因此可以最大限度地减少表面离子溅射、紫外光子辐射和电荷。远程模式样品清洗主要是表面化学反应,中性自由基从远程等离子体源扩散出来。浸没模式等离子清洗通常比远程模式等离子清洗更快。远程模式比浸没模式更温和。由于在远程模式等离子体清洗中大多不存在物理离子溅射,因此纯氩等离子体不会非常有效。通常,应在工艺气体中添加氧气或氢气,以进行远程模式等离子清洗。
浸没(左)和远程(右)等离子清洗模式 十一、等离子清洗的局限性等离子清洗可有效去除厚度小于几微米的有机污染物。尽管可以用氧等离子体灰化较厚的有机污染物层,但时间可能比溶剂清洁方法长。在某些情况下,不能使用氧等离子体,因为铜和银等活性金属很容易被氧等离子体氧化。纯氩离子溅射清洗方法在去除一层厚厚的有机污染物方面不是很有效。如果芯片有厚厚的焊料、粘合剂或胶带残留物,最好使用溶剂清洁方法去除大部分残留物,然后进行等离子清洗过程以实现原始表面清洁。 对于表面氧化物或氮化物,厚度应为数十纳米或更小,以便等离子体清洁对氩气或氩气+水合物有效。在正常室温下,它不能去除表层深处的氧化物或氮化物。 等离子清洗在去除晶圆切割过程中产生的大锯末或颗粒/碎屑方面可能不是很有效,因为这些污染物通常是大的无机颗粒或沉积物,不能轻易被氩气、氩气+氧气或氩气+氢等离子体蚀刻或溅射掉。 本文来自:http://www.whyueyi.com/Article-3249743.html | 产品分类
|